一、氮氧化硅(SiON)材料
氮氧化硅(Silicon Oxynitride,化学式SiON)是一种由硅(Si)、氧(O)和氮(N)组成的非晶态化合物。其性质介于二氧化硅(SiO₂,k=3.9)和氮化硅(Si₃N₄,k=7.5)之间,通过调节氮氧比例(N/O比),可灵活调控其介电常数(k=4.5–7.0)、折射率(1.6–2.1)。SiON的独特优势使其成为芯片制造中的多面手材料。
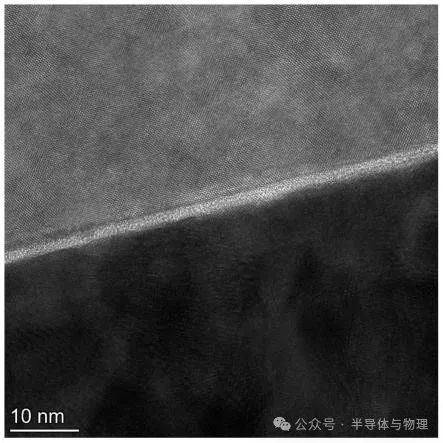
二、SiON的合成工艺与原料
SiON的制备方法主要包括化学气相沉积(CVD)、原子层沉积(ALD)和热氮化工艺,不同工艺的原料及反应机理如下:
化学气相沉积(CVD)
前驱体组合
- 硅源:硅烷(SiH₄)、四乙氧基硅烷(TEOS)。

原子层沉积(ALD)
热氮化工艺(SiO₂氮化)
将SiO₂薄膜置于NH₃或N₂/H₂气氛中高温退火(800–1000℃),部分氧被氮取代生成SiON。常用于传统CMOS工艺中栅氧化层的氮化改性,提升介电性能。
三、SiON在芯片制造中的核心作用
光刻抗反射层(ARC)
SiON的折射率(~1.8)介于光刻胶(~1.7)和硅衬底(~3.9)之间,可减少光反射(反射率<5%),提升光刻图案分辨率。图案转移硬掩膜层
SiON的硬度(~12 GPa)显著高于光刻胶(~0.5 GPa),在刻蚀工艺中可保护底层材料。- 以光刻胶为掩膜,干法刻蚀SiON层(使用CF₄/CHF₃等离子体)。
- 以SiON为硬掩膜刻蚀下层材料(如多晶硅或金属)。
高k栅极介电层
替代传统SiO₂
通过氮化工艺将栅氧化层(SiO₂)部分转化为SiON,介电常数提升至~5.0,降低等效氧化层厚度(EOT),增强栅控能力。技术指标
在28 nm制程中,SiON栅介质的EOT可达1.0 nm以下,漏电流降低1-2个数量级。
浅沟槽隔离(STI)的侧壁保护层
作用
在STI刻蚀后,沉积SiON作为侧壁保护层,防止后续工艺中氧化物填充层(如HDP SiO₂)的损伤。